气源分子束外延GSMBE、高真空化学气相沉积HVCVD
金属有机物分子束外延MOMBE、激光辅助沉积、化学束外延
融合了MBE和CVD优点,适合生长III-V族半导体薄膜,可以用于Si, SixGe1-x, FeSi2薄膜沉积, 以及氧化物薄膜,包括但不限于LiTaO3, 超导氧化物, TiO2, Al2O3, 掺铒Al2O3, Y2O3, CdO, HfO2, LiNbO3, MgO, ErSiO, ZnO, ZrO2等。
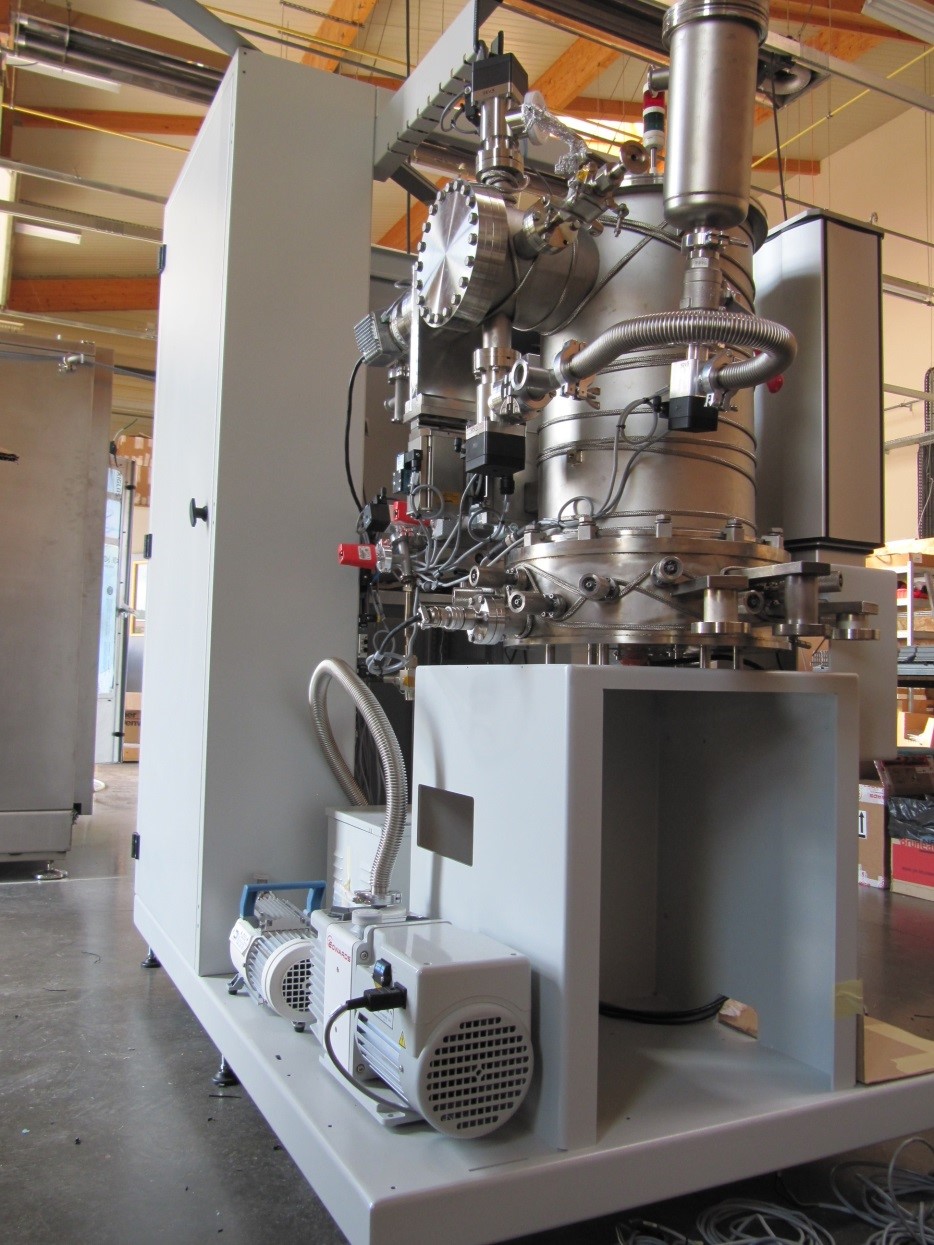
A – 高真空化学气相沉积系统由下列基本单元组成:
1. 热漆外框架和挡板
2. 含液氮冷阱的温控反应腔体
3. 样品台和衬底加热系统用于4’’或6’’晶圆.
4. 真空系统,包括阀和测量仪表
5. 全自动真空进样室(load-lock)
6. 专用扩散源(数量可选、组合方式可选)
7. 控制面板(操作软件)
8. 激光辅助沉积(可选)
1 热漆外框架和挡板
· 工业外框架容纳整套设备基本单元,4个角减震器能减小外部震动对设备操作影响和保证低磨损
· 一个挡板保护操作者远离危险区域(热、电等),这个挡板保证设备在制造时符合2006/42标准
· 漆的颜色采用标准的RAL7035,用户也可以选择其他颜色。

2 液氮冷阱温控反应腔体
· 主要反应沉积腔体采用温控腔壁,因此可以保证获得均匀且可控温度和低热量损失。为了获得良好的设备清洗效果,在吹扫过程中限制了前驱体的凝结。
· 沉积过程中,采用一个围绕衬底的圆柱形液氮冷阱来捕获寄生分子(parasitic molecules),它能够确保高速率生长(TiO2和LiNbO3标准前驱体生长速率数μm/h,但前驱体种类不同生长速率不同)。为了保证沉积物化学成分中杂质含量少,气体到达衬底均匀性要好、无凝结水或副产品。
· 钼支撑构建能承受小于1500℃的高温,允许晶圆在沉积腔体中定位,且兼容Load-Lock传动手臂。
· 腔体安装了标准法兰用于排气、气压测量、原位监测设施等。根据需要,可以要求额外的法兰。
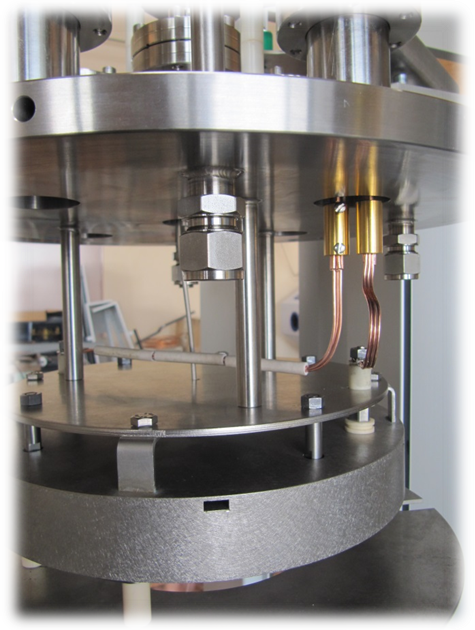
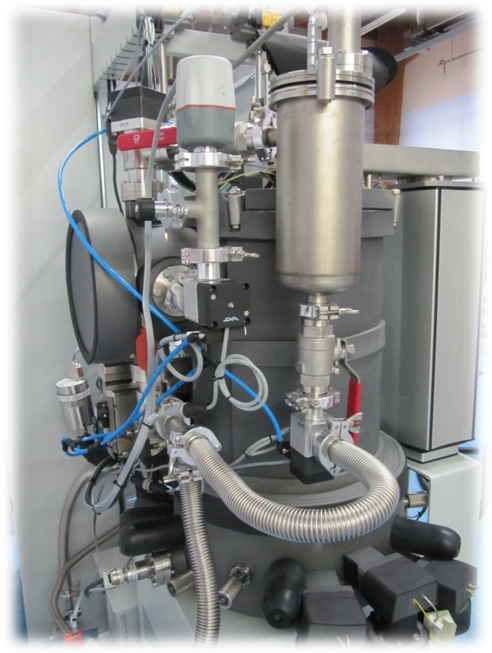
3 加热到700°C
· 一个最大功率2kW加热器通过辐射加热衬底,最低温度700℃(对于硅,需要10W/cm2的功率才能达到这个温度)。这个电阻石墨加热器通过功率调节控制。
· 在加热区域安装一个热电偶来读出加热区域的问题度。功率调节通过远程控制单元完成。
4 抽气系统、阀门和测量仪表
· 抽气系统由70 l/s的分子泵和10m3/h的主泵组成。
· 一个阀门将分子泵和反应腔体隔离开,以便在吹扫系统时保护分子泵。当沉积腔体中气压增加或者其他突发意外时,安全系统自动管理阀门来保护分子泵。一个“dual-gauge”测量腔体压力,一个皮拉尼真空计测量分子泵和干泵之间的压力。
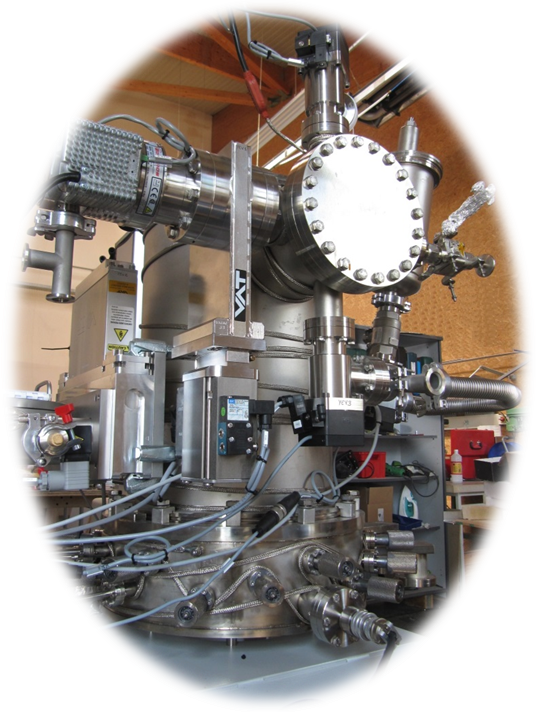
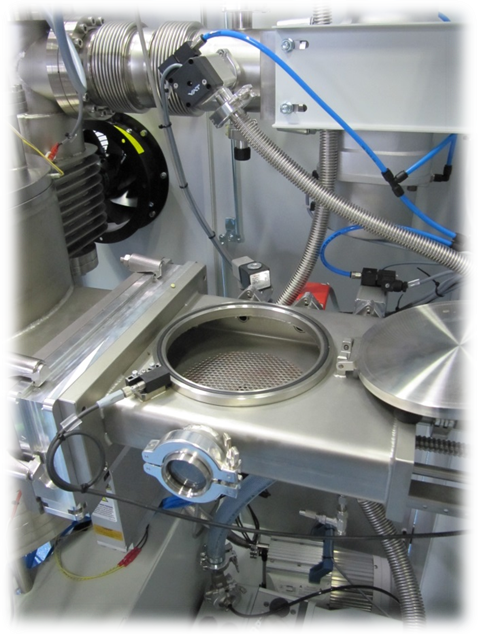
5 全自动真空进样室
· 全自动样品传动系统允许加载和卸载直径150mm以内的衬底(平面,标准厚度)到沉积腔体。
· 一个初级泵为Load-Lock腔体提供真空环境,允许阀门打开而保持主沉积腔体真空度。
6 专用扩散源(effusive sources):
· 专用扩散源放置在晶圆下方一个精确的距离,该扩散源由一些独立电路组成,分别用于各种物质(3个独立化学前驱体),使得前驱体可以均匀扩散,且各种前驱体之间(或与激光束之间)在腔体中的气相相互相互作用非常有限。
· 电路在不同温度下(高达150℃)可以温控,每个电路拥有独立的压力计(范围10-3至1mbar,或根据用户需求而定)。无过滤或保设施施应对有毒、易爆或其他危险化学物质,如果使用此类物质,用户需要自行负责安全问题。(扩散源撞击速率)在90%的衬底表面实现优于+/-5%均匀性。
· 一个质量流量控制器用于标定测量
· 化学前驱体存储在温控(高达120℃)储器中,并且通过一个真空电子阀门和标准手动阀门来与之前描述的扩散源隔离开来。阀门的开启通过远程控制单元实现。
· 生长过程中束辐照设施,包括:
- 一个透明光学窗口安装在一个法兰上(CF 或KF),用来在沉积过程中实现激光照射:因此,在生长薄膜过程中进行薄膜性能图案化变得可能。一个改进低温板用来避免在光学窗口上沉积。
- 在激光图案化过程中应当避免试用衬底旋转,但同时仍然能够保持撞击速率的均匀性。
- 光学窗口可以被等离子体源或电子-离子束装置替换。
- 不含激光器和光学部件用于图像投影,也不提供等离子体源、电子-离子束部件
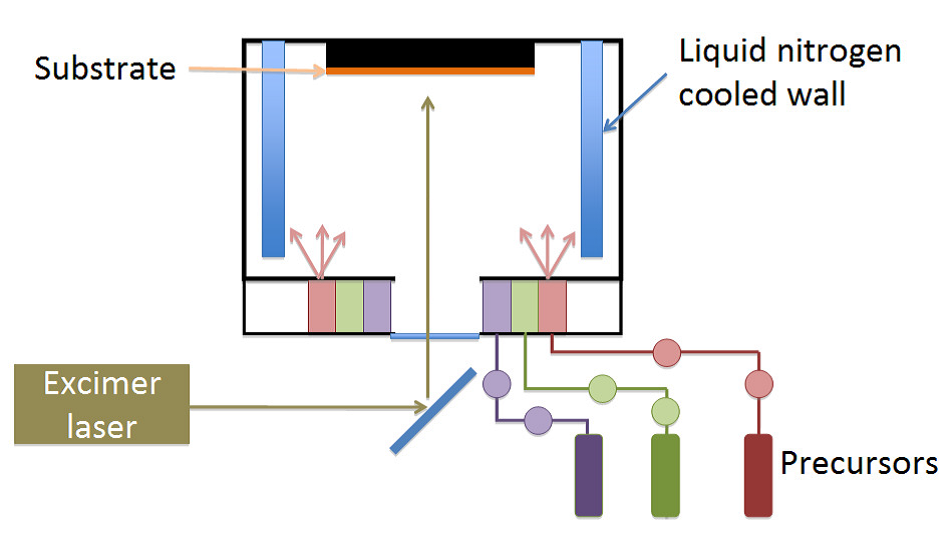
7 控制面板:
· 工业电脑专门用于控制工艺流程,操作人员使用19英寸触摸屏,PLC用于控制设备中的活动部件
· 可以通过网络远程控制,进行协助和问题处理;可以在自动或手动模式下使用设备

8 衬底旋转组件
· 可选衬底旋转用于改善厚度/流量均匀性,可以在衬底表面90%区域内实现优于+/-2%厚度均匀性
9 (扩散源)组合(方法)设施
· 每个扩散源(effusive source)被分成中心对称均匀分布的6个区域(扩散源),每个区域可以通过远程控制来实现该区域独立的打开和关闭。

· 如果所有区域打开,那么就获得如图曲线⑥所示的均匀分布沉积薄膜;如果其中一部分区域关闭,那么将获得梯度沉积(图中曲线①—⑤)。这样的一种配置被称作“可逆组合设施”,通过一次这样的实验可以获得薄膜厚度和化学成分梯度对这种材料性能影响的整个数据。这种梯度因子在6英寸范围内可以获得150+/-15%至600%+/-50%。
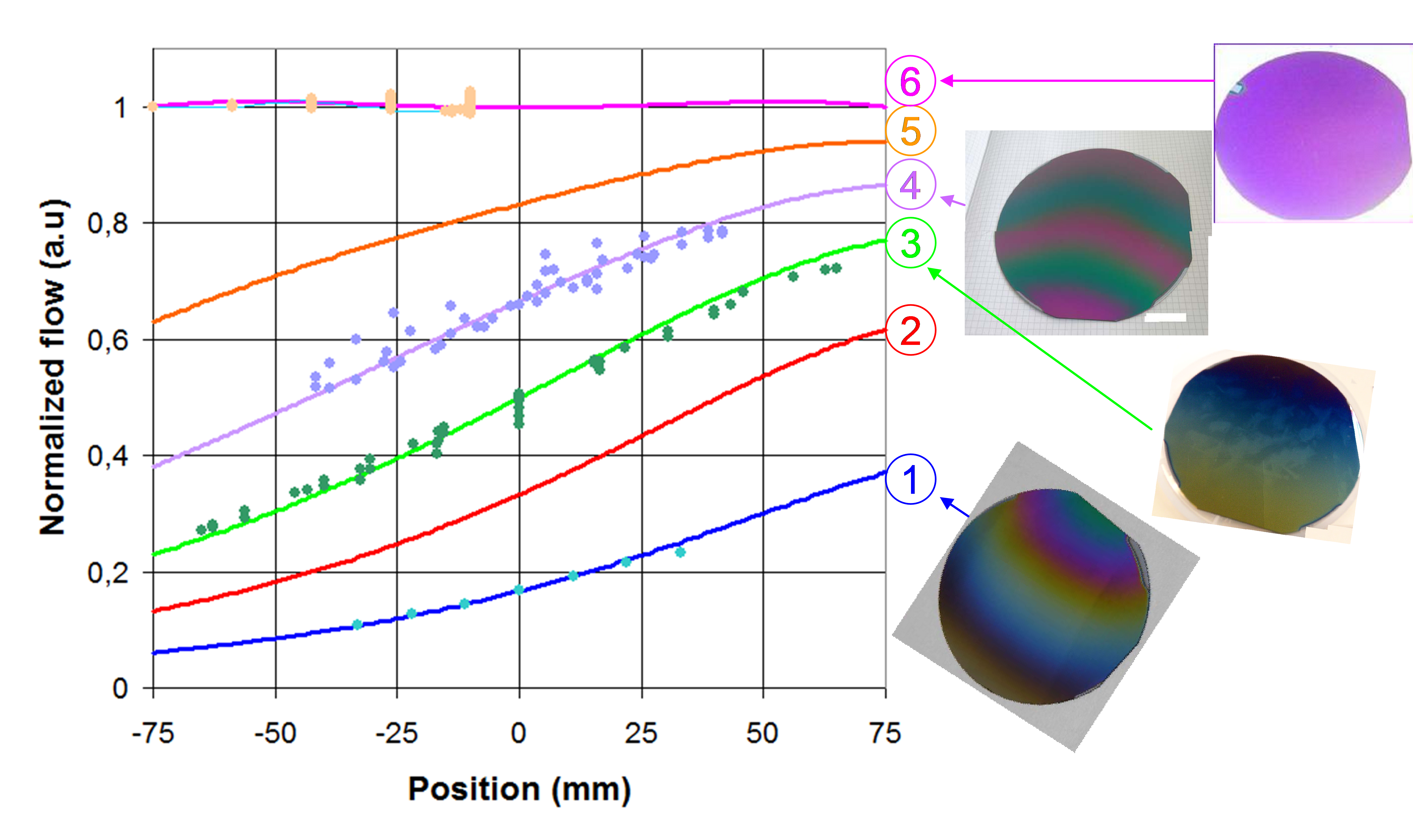
10 激光器与光学组件
· 可以选择所需激光器,例如CompexPro 205F激光器,型号 1115131
· 10x10 cm的均化器用于 248 nm 波长:Zoom +/-10%,均匀性 +/-5%,Field approx 600 mm
· 适合248nm的扫描器用于10x10 cm2照射表面扫描

B 出厂验收测试
一周内完成以下内容:
· 主腔体:真空度 < 5.10-6 mbar;Load-Lock:真空度 < 5.10-2 mbar ;样品传送机构运行情况测试;
· 衬底加热情况测试 (T = 500°C +/- 5°C);每个前驱体加热情况测试 (T = 50°C +/- 0.25°C);
· 扩散源流量校准测试,采用1-10sccm 氮气;液氮冷阱测试;
· 简单材料(TiO2)测试设备镀膜均匀性(+/-5%);测试LiNbO3和LiTaO3材料在组合模式下沉积;
· 签署FAT工厂测试报告;支付及发货安排;
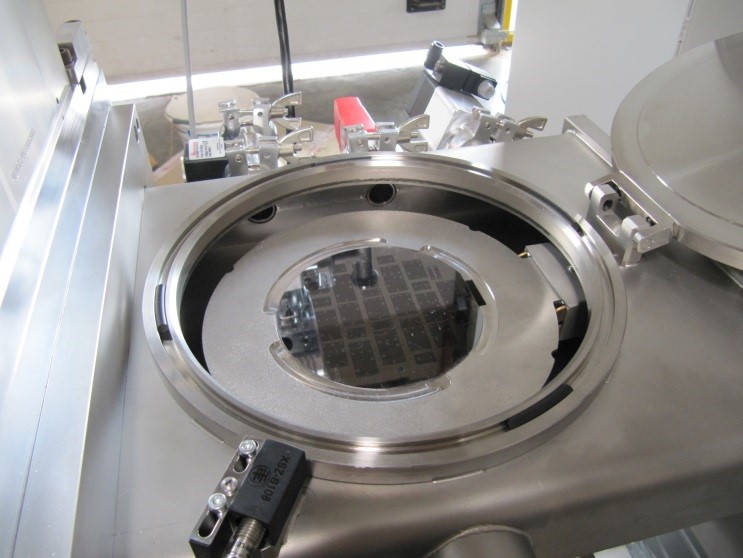
设备基本配置
· 主沉积腔体适合6’’衬底(或适合4’’衬底可选)
· 基本扩散源前驱体、额外前驱体源(最多5个)
· 兼容激光辐照(预留窗口),不含衬底旋转 (扩散源)组合方法设施
· 安装、调试、培训及演示
· 衬底旋转、激光设施、均化器、扫描仪(可选)